La-FMD ALD Precursor para futuros produtos de lógica e memória de ponta
Elementos de terras raras entraram na fabricação de alto volume para dispositivos lógicos avançados desde o nó de 32 nm (IBM, Samsung e Globalfoundries – Chipworks 2010). Especialmente para o lantânio (La) - o epônimo da série de lantanídeos na tabela periódica foi implementado como um dopante na pilha de portas metálicas de alto k. Óxido de lantânio (La2O3, constante dielétrica ~ 27), por exemplo, tem sido explorado por duas décadas como um dielétrico de porta de alto k para a substituição do dióxido de silício convencional (SiO2) dielétrico de porta nos transistores de próxima geração em lógica, bem como em memórias dinâmicas de acesso aleatório (DRAMs).

Segmentação de palavras-chave de pedidos de patentes dos últimos 20 anos para Lantânio e"Deposição de Camada Atômica" [Pesquisa Patbase 15 de novembro de 2018]
A deposição de camada atômica é o método mais promissor para o crescimento de filmes ultrafinos de dielétricos de porta baseados em La e, portanto, tem sido alvo de extensa pesquisa e depósito de pedidos de patente nos últimos 20 anos. O esforço de P&D tem se concentrado em campos relacionados a aplicações dielétricas e dielétricas de alto k na indústria de semicondutores (veja a segmentação de palavras-chave acima). O crescimento de filme atômico camada por camada facilitado por reações de superfície autolimitantes em ALD fornece controle de espessura de filme atomicamente preciso, boa uniformidade em um substrato de grande área e excelente conformabilidade no caso de estruturas de alta relação de aspecto, como FinFETs modernos e estruturas de pilar do tipo capacitor de memória. No entanto, para funcionar perfeitamente, requer os precursores de ALD que têm propriedades específicas (LINK):
1. Suficientemente voláteis (pelo menos ~ 0.1 Torr de pressão de vapor de equilíbrio a uma temperatura na qual não se decompõem termicamente).
2. Vaporização rápida e a uma taxa reproduzível (condições que geralmente são atendidas para precursores líquidos, mas não para sólidos).
3. Não reage nem se decompõe na superfície ou na fase gasosa (para reações de superfície autoterminantes).
4. Altamente reativo com o outro reagente previamente ligado à superfície, o que resulta em cinética relativamente rápida e, portanto, temperaturas de ALD e tempos de ciclo mais baixos.
5. Subprodutos voláteis que podem ser facilmente purgados para preparar o meio ciclo subsequente.
6. Subprodutos não corrosivos para evitar não uniformidades devido à corrosão da ferramenta e corrosão do filme.
Em 2007, a Intel Corporation incorporou a HfO2em pilha dielétrica de porta de alto k no nó de tecnologia de 45 nm. No entanto, HfO puro2sofre de problema de camada de interface de baixo k com Si, limitando valores de espessura de óxido equivalente (EOT) mais baixos. Ele também cristaliza prontamente em temperaturas tão baixas quanto ~500 graus. Portanto, dielétricos amorfos com alta estabilidade térmica ainda são procurados para nenhum defeito intrínseco (por exemplo, limites de grãos), desde que ainda ofereçam as vantagens de HfO2, como alta constante dielétrica, ampla lacuna de banda e baixa corrente de fuga. Óxidos ternários à base de lantânio, como escandato de lantânio (LaScO3) e óxido de lantânio lutécio (LaLuO3), depositados pelo processo ALD envolvendo precursores de amidinato metálico, supostamente exibem propriedades estruturais e elétricas desejáveis. De fato, LaLuO3é potencialmente o melhor dielétrico de porta de fase amorfa com constante dielétrica k~32. Ele não forma camadas interfaciais de baixo k com Si, o que permite valores de espessura efetiva de óxido (EOT) < 1 nm com corrente de fuga significativamente baixa. Outro fator que contribui para a baixa corrente de fuga em ALD crescido fino LaLuO3gate dielétrico é o grande deslocamento de banda (2,1 eV) com relação ao Si; os deslocamentos simétricos de banda de condução e valência resultam em correntes de vazamento iguais em NMOSFETs acionados por elétrons e PMOSFETs acionados por buracos. Ele permanece amorfo e não forma ligas com Si ou Ge após os respectivos recozimentos de ativação de fonte/dreno.

Como um exemplo muito recente de uma aplicação real de alta razão de aspecto em wafers de 300 mm que exigem todas as características precursoras de ALD descritas acima (1 a 6), podemos ver o artigo que a Imec apresentou nesta famosa conferência IEDM, sobre o uso de uma camada LaSiOx como um dipolo inserido na pilha HKMG. A Imec teve sucesso em empilhar o módulo de front-end FinFET completo em cima de um módulo FinFET de silício a granel "padrão", demonstrando também um bom ajuste de tensão de limiar, confiabilidade e desempenho em baixa temperatura. Presumivelmente, ele provavelmente foi depositado por um processo ALD, pois terá que revestir as aletas de forma conforme e garantir controle de espessura preciso e uniformidade: IEDM2018 Artigo nº 7.1, "Primeira demonstração de FinFETs empilhados em 3D em um passo de aleta de 45 nm e tecnologia de passo de porta de 110 nm em wafers de 300 mm", A. Vandooren et al, Imec.
Como neste caso e em muitos outros, as qualificações rigorosas para precursores de ALD os colocam na categoria de produtos químicos especiais de alta qualidade - os materiais ou moléculas de desempenho ou função específicos de escolha. As propriedades do filme depositado são fortemente influenciadas pelas propriedades físicas e químicas de uma única molécula ou uma mistura formulada de moléculas, bem como sua composição química. Portanto, isso coloca muita pressão sobre o fabricante e o fornecedor de produtos químicos especiais de alta pureza em termos de qualidade, pureza, procedimentos de documentação, atendimento ao cliente, etc.
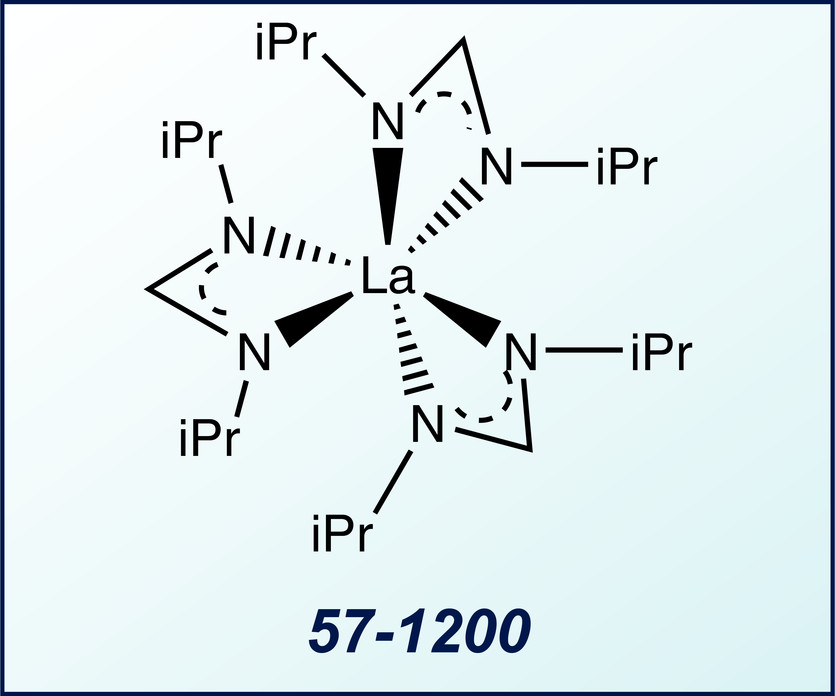
Tris(N,N'-di-i-propilformamidinato)lantânio(III), (99.999+%-La) La-FMD é um dos precursores de amidinato de metal para La ALD. O material é um pó branco a esbranquiçado. A fórmula química e o peso molecular de La-FMD são C21H45LaN6e 520,53, respectivamente. A Rohm and Haas Electronic Materials LLC (posteriormente Dow Chemical) relata La-FMD como o precursor de La mais volátil conhecido até agora. A pressão de vapor a uma dada temperatura transmitida por La-FMD é maior do que a de La(Cp)3e La(thd)3. Além disso, Roy G. Gordon da Universidade de Harvard relata que os precursores de amidinato são termicamente mais estáveis do que suas contrapartes amidas por causa do ligante amidinato quelante e da ausência de ligação MC. Os amidinatos de La são altamente reativos com ligações Si-H, produzindo um tempo de saturação de superfície muito menor e, por sua vez, uma rápida autoterminação da meia-reação ALD; encurtando assim o tempo do ciclo ALD. Além disso, uma excelente cobertura de superfície é fornecida pelos precursores de amidinato de La em Si terminado em hidrogênio.
Origem de: https://www.strem.com/catalog/product_blog/160/1/strem_oferece_novo_la-fmd_ald_precursor_para_futuros_produtos_de_lógica_e_memória_de_ponta{{17}}
